18 September
Intel, похоже, очень воодушевлена стеклянными подложками
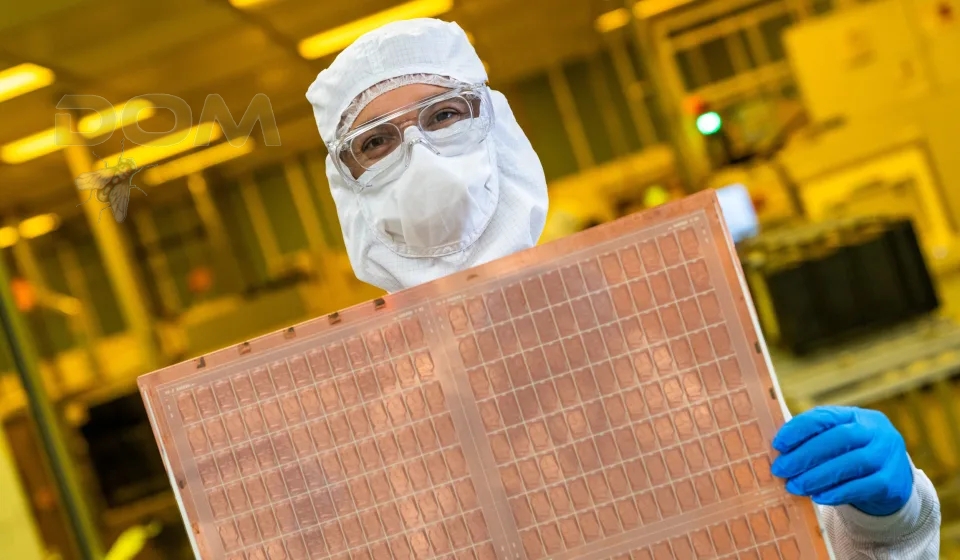 Сегодня, когда мы говорим о том, что будет дальше с дизайном чипов, мы сосредотачиваемся на таких вещах, как увеличение количества ядер, увеличение тактовой частоты, уменьшение количества транзисторов и 3D-стекинг. Мы редко думаем о подложке корпуса, которая удерживает и соединяет эти компоненты. Сегодня Intel, в процессе своего переосмысления в литейную компанию, объявила, что совершила крупный прорыв в материалах подложек — и все дело в стекле.
Сегодня, когда мы говорим о том, что будет дальше с дизайном чипов, мы сосредотачиваемся на таких вещах, как увеличение количества ядер, увеличение тактовой частоты, уменьшение количества транзисторов и 3D-стекинг. Мы редко думаем о подложке корпуса, которая удерживает и соединяет эти компоненты. Сегодня Intel, в процессе своего переосмысления в литейную компанию, объявила, что совершила крупный прорыв в материалах подложек — и все дело в стекле.Компания заявляет, что ее новая стеклянная подложка, которая появится в передовых конструкциях чипов позднее в этом десятилетии, будет прочнее и эффективнее существующих органических материалов. Стекло также позволит компании размещать больше чипсетов и других компонентов рядом друг с другом, что может привести к изгибу и нестабильности существующего кремниевого корпуса, изготовленного из органических материалов.
«Стеклянные подложки выдерживают более высокие температуры, обеспечивают на 50% меньше искажений рисунка, имеют сверхнизкую плоскостность для улучшения глубины резкости при литографии, а также обладают размерной стабильностью, необходимой для чрезвычайно плотного наложения межслойных соединений», — заявила Intel в пресс-релиз. Компания утверждает, что благодаря этим возможностям стеклянные подложки также приведут к десятикратному увеличению плотности межсоединений, а также позволят создавать «корпусы сверхбольшого форм-фактора с очень высокой производительностью сборки».
Мы постепенно начинаем понимать, как на самом деле могут выглядеть будущие чипы Intel. Два года назад компания анонсировала свою конструкцию транзистора с универсальным затвором RibbonFET, а также PowerVia, которая позволит Intel перенести подачу питания на заднюю часть пластины чипа. В то же время Intel также объявила, что будет создавать чипы для Qualcomm и сервиса Amazon AWS.
Intel заявляет, что в первую очередь мы увидим чипы, использующие стеклянные подложки, в областях с высокой производительностью, таких как искусственный интеллект, графика и центры обработки данных. Прорыв в производстве стекла является еще одним признаком того, что Intel также наращивает свои передовые возможности в области упаковки для своих литейных заводов в США. Сообщается, что именно с этим сталкивается TSMC на своем заводе в Фениксе, штат Аризона, которому потребуется отправлять материалы чипов обратно на Тайвань для усовершенствованной упаковки.